在曝光过程中,通过移动掩膜来控制光刻胶表面的曝光能量分布。能够制作有任意曲面及倾斜的三维微细构造体。
主要特长
- 采用独自的镜面・镜头光学系统,实现全面均匀的照射。
- 配备有可设定非接触・面内均一间隙的间隙传感器和对应多层曝光的显微镜、X・Y・θ轴对位台的对位系统。
- 采用Moving UV mask法(使用Piezo Positioning Stage,使掩膜在曝光中微细移动)能够控制厚膜光刻胶的侧壁倾斜角度,形成三维微细构造体。
光刻胶膜厚50μm时的图形例
L/S=50μm
掩膜移动量=20μm
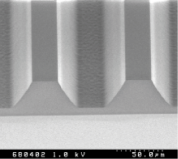
Dot=Φ50μm
掩膜移动量=Φ25μm
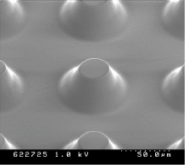

主要规格
| MUM系列 | ||
|---|---|---|
| 掩膜尺寸 | Max 9″ x 9″ x t3.0 mm | |
| 基板尺寸 | Max Φ8″(Wafer) | |
| 光源 | 超高压水银灯:500W or 1kW | |
| 外观尺寸及重量 | 本体尺寸 | W2120 x D1305 x H1850 mm |
| 本体重量 | 640kg | |
※基板尺寸和水银灯瓦数及特殊规格可商洽


